home > Programm
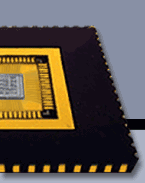
18. Workshop „Testmethoden und Zuverlässigkeit von Schaltungen und Systemen“
12. bis 14. März 2006, Maritim Hotel, Titisee

Sponsoren
Programmkomitee
Beitrag einreichen
Vorläufiges Programm (PDF-Version)
Sonntag, 12. März 2006 |
|
| 18:00 Uhr |
Abendessen |
| 19:00 Uhr – 20:00 Uhr |
Begrüßung und Fachgruppensitzung |
| 20:00 Uhr – 21. 00 Uhr |
Panel: Test, Diagnose und Zuverlässigkeit in zukünftigen elektronischen SystemenModeration: S. Hellebrand, Universität Paderborn, Paderborn, DeutschlandTeilnehmer: J. Alt, Infineon Technologies AG, München, Deutschland; B. Becker; Albert-Ludwigs-Universität, Freiburg, Deutschland; S. Eichenberger, Philips Semiconductors Nijmegen, Niederlande; M. Keim, Mentor Graphics, Wilsonville, USA; B. Straube, Fraunhofer IIS / EAS Dresden, Dresden, Deutschland; H.-J. Wunderlich, Universität Stuttgart, Deutschland |
Montag, 13. März 2006 |
|
| 9.15 Uhr – 9.30 Uhr |
Eröffnung |
| B. Becker; Albert-Ludwigs-Universität, Freiburg, Deutschland | |
| 9.30 Uhr – 10.30 Uhr |
Eingeladener Vortrag |
|
Test Challenges for Next Generation High Volume
CPU Designs
R. Galivanche; Intel Santa Clara, USA |
|
| 10.30 Uhr – 11:00 Uhr |
Kaffeepause |
| 11:00 Uhr – 12.30 Uhr |
1. Sitzung: Test and Diagnosis in a Non-Digital EnvironmentSitzungsleitung: H.-J. Jentschel; Technische Universität Dresden, Dresden, Deutschland |
|
Verifikation eines ADC-Testverfahrens für
Multi-Site Produktionstest mit rein digitalen
Ressourcen H. Mattes, S. Kirmser, S. Sattler; Infineon Technologies AG, München, Deutschland Mixed-Signal Test Software Generation Process - Metrics, Software Engineering Methods and Tools for Improving Quality and Productivity H.M. von Staudt1, S. Vock2; 1Dialog Semiconductor, Kirchheim/Teck, Deutschland, 2SEPT Europe, Baierbrunn (München), Deutschland Fehlerdiagnose von Analogschaltungen unter Verwendung eines analogen Fehlersimulators B. Straube1, W. Vermeiren1, M. Lindig1, T. Coym1, L. Grobelny2, A. Lerch2; 1Fraunhofer-Institut für Integrierte Schaltungen, Dresden, Deutschland, 2ZMD Analog Mixed Signal Services GmbH & Co. KG, Dresden, Deutschland |
|
| 12.30 Uhr – 14.30 Uhr |
Mittagessen |
| 14.30 Uhr – 16:00 Uhr |
2. Sitzung: Reliability, Fault and Error ToleranceSitzungsleitung: J. Schlöffel; Philips Semiconductors GmbH, Hamburg, Deutschland |
|
The Role of Realistic Reliability,
Availability, Maintainability and Testability
Parameters (RAMT) on System Level W. Hoppe; Rheinmetall Defence Electronics GmbH, Bremen, Deutschland Ein dynamisch rekonfigurierbarer superskalarer Prozessor mit den Modi Sicherheit und Performanz T. Kottke1, A. Steininger2; 1EADS Deutschland GmbH, München, Deutschland, 2Technische Universität Wien, Österreich Period of Grace: A New Paradigm for Efficient Soft Error Hardening I. Polian1,2, B. Becker2, M. Nakasato1, S. Ohtake1, H. Fujiwara1; 1Graduate School of Information Science, Ikoma City, Japan, 2Albert-Ludwigs-Universität, Freiburg, Deutschland |
|
| 16:00 Uhr – 17:00 Uhr |
Poster Sitzung und Kaffeepause |
|
Efficiency of Multi-Valued Encoding in
SAT-based ATPG G. Fey, J. Shi, R. Drechsler; Universität Bremen, Deutschland JTAG/Boundary Scan Systeme in der Praxis R. Dreßler; GÖPEL electronic GmbH, Jena, Deutschland Reliability Testing of Three-Dimensional Silicon Force Sensors S. Spinner1, J. Bartholomeyczik1, B. Becker1, M. Doelle1, O. Paul1, I. Polian1, R. Roth2, K. Seitz2, P. Ruther1; 1Albert-Ludwigs-Universität, Freiburg, Deutschland, 2Carl Zeiss Industrielle Messtechnik GmbH, Oberkochen, Deutschland Messung von Empfindlichkeitsprofilen an Fotodioden M. Meister1, H. Pless2; 1Institut für Mikroelektronik- und Mechatronik-Systeme gGmbH, Ilmenau, Deutschland, 2Melexis GmbH, Erfurt, Deutschland Analyse von versorgungsstrombasierten Messdaten zur Gewinnung von Test-Entscheidungsschwellen M. Arabackyj; Friedrich-Alexander-Universität, Erlangen-Nürnberg, Deutschland Statistische Analyse des Zeitverhaltens von CMOS Schaltungen und Modellierung von Parametervariationen F. Sill, C. Cornelius, D. Timmermann; Universität Rostock, Deutschland Möglichkeiten und Grenzen für den hierarchischen Selbsttest von "Systems on a Chip" R. Kothe, S. Schultke, C. Galke, H.T. Vierhaus; BTU Cottbus, Deutschland Eingebettete Selbstreparatur durch Rekonfiguration von FPGAs S. Habermann, R. Kothe, H.T. Vierhaus; BTU Cottbus IddQ Testing of Resistive Bridging Defects P. Engelke1, I. Polian1, H. Manhaeve2, M. Renovell3, B. Becker1; 1Albert-Ludwigs-Universität, Freiburg, Deutschland, 2Q-Star Test, Brugge, Belgien, 3LIRMM – UMII, Montpellier, Frankreich |
|
| 17:00 Uhr – 18.30 Uhr |
3. Sitzung: Issues in SOC and System TestSitzungsleitung: V. Schöber; edacentrum e. V., Hannover, Deutschland |
|
Kompaktor Architektur zur Reduktion und
Kompensation von Test- und Diagnosedaten
On-Chip J. Rzeha1, M. Beck2, F. Pöhl2, M. Gössel1; 1Universität Potsdam, Deutschland, 2Infineon Technologies AG, München, Deutschland (KURZVORTRAG) Reduction of Test Time Using Serialized/Deserialized Scan Data Transfer M. Seuring; AMD Saxony LLC & Co. KG, Dresden, Deutschland (KURZVORTRAG) An Advanced Memory Built-in Self Test Controller K. Hesse, M. Seuring; AMD Saxony LLC & Co. KG, Dresden, Deutschland ExTraCT: A New Approach for the Transparent Test of Time-Triggered Communication Services E. Armengaud; Vienna University of Technology, Österreich |
|
| 20:00 Uhr – 22:00 Uhr |
Abendessen |
Dienstag, 14. März 2006 |
|
| 8.30 Uhr – 10.30 Uhr |
4. Sitzung: RF ChallengesSitzungsleitung: S. Sattler; Infineon Technologies AG, München, Deutschland |
|
A Built-In-Self-Test view on estimation of
mixer-parameters of direct conversion receiver
front-ends R. Müller, H.-J. Jentschel; Technische Universität Dresden, Dresden, Deutschland RF Built-In Self-Test for Integrated Transmitters Using Sigma-Delta Techniques C. Münker1, R. Weigel2; 1Infineon Technologies AG, München, Deutschland, 2Friedrich-Alexander-Universität, Erlangen-Nürnberg, Deutschland Integrierte RF-CMOS-Transceiver - neue Herausforderungen für den Produktionstest F. Demmerle; Infineon Technologies AG, München, Deutschland Teststrategien für HF-ICs vom Labor zur Produktion B. Bieske1, P. Witzenhausen1, A. Brenneke2; 1Institut für Mikroelektronik- und Mechatronik-Systeme gGmbH, Ilmenau, Deutschland, 2Melexis GmbH, Erfurt, Deutschland |
|
| 10.30 Uhr – 11:00 Uhr |
Kaffeepause |
| 11:00 Uhr – 12:00 Uhr |
5. Sitzung: Processor Self Test and PowerSitzungsleitung: M. Kessler; IBM Entwicklungs GmbH, Böblingen, Deutschland |
|
|
Softwarebasierender Selbsttest von Prozessoren
bei beschränkter Verlustleistung J. Zhou, H.-J. Wunderlich, T. Bergmann; Universität Stuttgart, Deutschland BIST Power Reduction Using Scan-Chain Disable in the Cell Processor C. Zoellin1, H.-J. Wunderlich1, N. Maeding2, J. Leenstra2; 1Universität Stuttgart, Deutschland, 2IBM Deutschland Entwicklung, Böblingen, Deutschland |
| 12:00 Uhr – 14:00 Uhr |
Mittagessen |




|
|